
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
En komplet forklaring af chipfremstillingsprocessen (1/2): fra wafer til pakning og test
2024-09-18
Fremstillingen af hvert halvlederprodukt kræver hundredvis af processer, og hele fremstillingsprocessen er opdelt i otte trin:wafer behandling - oxidation - fotolitografi - ætsning - tyndfilmaflejring - sammenkobling - afprøvning - emballage.
![]()
Trin 1:Wafer behandling
Alle halvlederprocesser starter med et sandkorn! Fordi siliciumet i sandet er det råmateriale, der skal til for at producere wafers. Wafers er runde skiver skåret af enkeltkrystalcylindre lavet af silicium (Si) eller galliumarsenid (GaAs). For at udvinde højrent siliciummaterialer kræves silicasand, et specielt materiale med et siliciumdioxidindhold på op til 95 %, som også er det vigtigste råmateriale til fremstilling af wafers. Waferforarbejdning er processen med fremstilling af ovenstående wafers.
Ingotstøbning
Først skal sandet opvarmes for at adskille carbonmonoxid og silicium i det, og processen gentages, indtil ultra-høj renhed elektronisk kvalitet silicium (EG-Si) opnås. Højrent silicium smelter til væske og størkner derefter til en enkelt krystal fast form, kaldet en "barre", som er det første trin i halvlederfremstilling.
Fremstillingspræcisionen af siliciumbarrer (siliciumsøjler) er meget høj og når nanometerniveauet, og den meget anvendte fremstillingsmetode er Czochralski-metoden.
Ingotskæring
Efter at det foregående trin er afsluttet, er det nødvendigt at skære de to ender af barren af med en diamantsav og derefter skære den i tynde skiver af en vis tykkelse. Diameteren af ingotskiven bestemmer størrelsen af waferen. Større og tyndere wafers kan opdeles i mere anvendelige enheder, hvilket er med til at reducere produktionsomkostningerne. Efter skæring af siliciumbarren er det nødvendigt at tilføje "fladt område" eller "bule" mærker på skiverne for at lette indstillingen af forarbejdningsretningen som standard i de efterfølgende trin.
Wafer overflade polering
Skiverne opnået gennem ovennævnte skæreproces kaldes "bare wafers", det vil sige ubearbejdede "rå wafers". Overfladen af den bare wafer er ujævn, og kredsløbsmønsteret kan ikke trykkes direkte på det. Derfor er det nødvendigt først at fjerne overfladedefekter gennem slibe- og kemiske ætsningsprocesser, derefter polere for at danne en glat overflade, og derefter fjerne resterende forurening gennem rengøring for at opnå en færdig wafer med en ren overflade.
Trin 2: Oxidation
Oxidationsprocessens rolle er at danne en beskyttende film på overfladen af waferen. Det beskytter waferen mod kemiske urenheder, forhindrer lækstrøm i at komme ind i kredsløbet, forhindrer diffusion under ionimplantation og forhindrer waferen i at glide under ætsning.
Det første trin i oxidationsprocessen er at fjerne urenheder og forurenende stoffer. Det kræver fire trin at fjerne organisk materiale, metalurenheder og fordampe resterende vand. Efter rensning kan waferen placeres i et højtemperaturmiljø på 800 til 1200 grader Celsius, og et siliciumdioxidlag (dvs. "oxid") dannes af strømmen af oxygen eller damp på overfladen af waferen. Ilt diffunderer gennem oxidlaget og reagerer med silicium for at danne et oxidlag af varierende tykkelse, og dets tykkelse kan måles efter oxidationen er afsluttet.

Tør oxidation og våd oxidation Afhængig af de forskellige oxidanter i oxidationsreaktionen kan den termiske oxidationsprocessen opdeles i tør oxidation og våd oxidation. Førstnævnte bruger ren oxygen til at producere et siliciumdioxidlag, som er langsomt, men oxidlaget er tyndt og tæt. Sidstnævnte kræver både ilt og meget opløselig vanddamp, som er kendetegnet ved en hurtig væksthastighed, men et relativt tykt beskyttende lag med lav densitet.
Ud over oxidanten er der andre variabler, der påvirker tykkelsen af siliciumdioxidlaget. For det første vil waferstrukturen, dens overfladedefekter og indre dopingkoncentration påvirke hastigheden af oxidlaggenerering. Derudover, jo højere tryk og temperatur, der genereres af oxidationsudstyret, jo hurtigere vil oxidlaget blive genereret. Under oxidationsprocessen er det også nødvendigt at bruge et dummy-ark i henhold til waferens position i enheden for at beskytte waferen og reducere forskellen i oxidationsgrad.
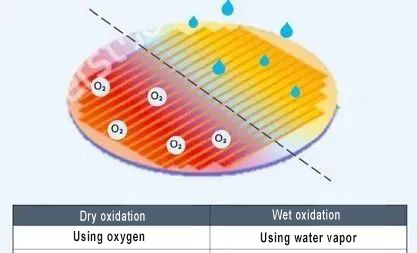
Trin 3: Fotolitografi
Fotolitografi er at "printe" kredsløbsmønsteret på waferen gennem lys. Vi kan forstå det som at tegne det plankort, der kræves til halvlederfremstilling på overfladen af waferen. Jo højere finhed kredsløbsmønsteret er, jo højere integration af den færdige chip, hvilket skal opnås gennem avanceret fotolitografiteknologi. Specifikt kan fotolitografi opdeles i tre trin: belægning af fotoresist, eksponering og fremkaldelse.
Belægning
Det første trin i at tegne et kredsløb på en wafer er at belægge fotoresisten på oxidlaget. Fotoresist gør waferen til et "fotopapir" ved at ændre dens kemiske egenskaber. Jo tyndere fotoresistlaget på overfladen af waferen er, jo mere ensartet er belægningen, og jo finere er det mønster, der kan udskrives. Dette trin kan udføres ved "spin coating"-metoden. Ifølge forskellen i lys (ultraviolet) reaktivitet kan fotoresists opdeles i to typer: positive og negative. Førstnævnte vil nedbrydes og forsvinde efter eksponering for lys, hvilket efterlader mønsteret af det ueksponerede område, mens sidstnævnte vil polymerisere efter eksponering for lys og få mønsteret af den eksponerede del til at fremstå.
Eksponering
Efter at fotoresistfilmen er dækket på waferen, kan kredsløbsudskrivningen fuldføres ved at kontrollere lyseksponeringen. Denne proces kaldes "eksponering". Vi kan selektivt sende lys gennem eksponeringsudstyret. Når lyset passerer gennem masken, der indeholder kredsløbsmønsteret, kan kredsløbet printes på waferen belagt med fotoresistfilmen nedenfor.
Under eksponeringsprocessen, jo finere det trykte mønster er, jo flere komponenter kan den endelige chip rumme, hvilket hjælper med at forbedre produktionseffektiviteten og reducere omkostningerne for hver komponent. På dette område er den nye teknologi, der i øjeblikket tiltrækker stor opmærksomhed, EUV-litografi. Lam Research Group har i fællesskab udviklet en ny tørfilm fotoresistteknologi med strategiske partnere ASML og imec. Denne teknologi kan i høj grad forbedre produktiviteten og udbyttet af EUV-litografieksponeringsprocessen ved at forbedre opløsningen (en nøglefaktor i finjustering af kredsløbsbredden).
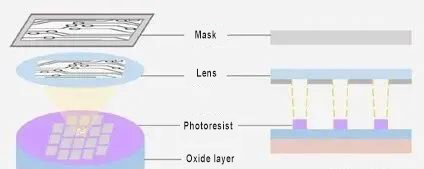
Udvikling
Trinnet efter eksponering er at sprøjte fremkalderen på waferen, formålet er at fjerne fotoresisten i det afdækkede område af mønsteret, så det trykte kredsløbsmønster kan afsløres. Efter at udviklingen er afsluttet, skal den kontrolleres af forskelligt måleudstyr og optiske mikroskoper for at sikre kvaliteten af kredsløbsdiagrammet.
Trin 4: Ætsning
Efter at fotolitografien af kredsløbsdiagrammet er afsluttet på waferen, bruges en ætsningsproces til at fjerne overskydende oxidfilm og efterlade kun halvlederkredsløbsdiagrammet. For at gøre dette bruges væske, gas eller plasma til at fjerne de valgte overskydende dele. Der er to hovedmetoder til ætsning, afhængigt af de anvendte stoffer: vådætsning ved hjælp af en specifik kemisk opløsning til kemisk at reagere for at fjerne oxidfilmen, og tørætsning ved hjælp af gas eller plasma.
Vådætsning
Vådætsning ved hjælp af kemiske opløsninger til at fjerne oxidfilm har fordelene ved lave omkostninger, hurtig ætsningshastighed og høj produktivitet. Imidlertid er vådætsning isotropisk, det vil sige, at dens hastighed er den samme i enhver retning. Dette bevirker, at masken (eller den følsomme film) ikke er helt på linje med den ætsede oxidfilm, så det er svært at behandle meget fine kredsløbsdiagrammer.

Tørætsning
Tørætsning kan opdeles i tre forskellige typer. Den første er kemisk ætsning, som bruger ætsende gasser (hovedsageligt hydrogenfluorid). Ligesom vådætsning er denne metode isotrop, hvilket betyder, at den ikke er egnet til finætsning.
Den anden metode er fysisk sputtering, som bruger ioner i plasmaet til at påvirke og fjerne det overskydende oxidlag. Som en anisotropisk ætsningsmetode har forstøvningsætsning forskellige ætsningshastigheder i vandret og lodret retning, så dens finhed er også bedre end kemisk ætsning. Ulempen ved denne metode er imidlertid, at ætsningshastigheden er langsom, fordi den udelukkende afhænger af den fysiske reaktion forårsaget af ionkollision.
Den sidste tredje metode er reaktiv ionætsning (RIE). RIE kombinerer de to første metoder, det vil sige, mens man bruger plasma til fysisk ioniseringsætsning, udføres kemisk ætsning ved hjælp af frie radikaler dannet efter plasmaaktivering. Ud over at ætsningshastigheden overstiger de to første metoder, kan RIE bruge ioners anisotrope egenskaber til at opnå højpræcisionsmønsterætsning.
I dag er tørætsning blevet brugt i vid udstrækning til at forbedre udbyttet af fine halvlederkredsløb. Opretholdelse af fuld-waferætsningens ensartethed og øget ætsningshastighed er kritisk, og nutidens mest avancerede tørætsningsudstyr understøtter produktionen af de mest avancerede logik- og hukommelseschips med højere ydeevne.

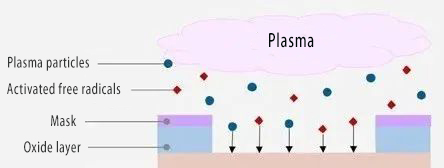
VeTek Semiconductor er en professionel kinesisk producent afTantalcarbid belægning, Siliciumcarbid belægning, Speciel grafit, Siliciumcarbid keramikogAnden halvlederkeramik. VeTek Semiconductor er forpligtet til at levere avancerede løsninger til forskellige SiC Wafer-produkter til halvlederindustrien.
Hvis du er interesseret i ovenstående produkter, er du velkommen til at kontakte os direkte.
Mobiltelefon: +86-180 6922 0752
WhatsAPP: +86 180 6922 0752
E-mail: anny@veteksemi.com




